1.2.1 本征型阻燃环氧
目前塑封料常用的环氧树脂有酚醛型、联苯型、双环戊二烯型和蔡型等环氧。酚醛型树脂具有较高的热稳定性和化学稳定性;联苯型树脂在常温下呈结晶状态,具有低豁度和高填充性等特点;双环戊二烯型树脂中的固化剂具有较低的吸湿率,耐热性好;萘型树脂具有高Tg和高耐热性能。同许多其他有机高分子材料一样,环氧树脂也易于燃烧,因此在使用过程中通常都要加人阻燃剂。日本NEC公司和Sumitomo Bakelite公司开展了此方面的研究。Mascctoshi[16]通过对苯酚-亚联苯基型和萘酚-亚苯基型环氧树脂的研究表明,芳环的键能比较大,在高温时不易发生分解,分子中芳环数量的增多会
提高阻燃性能。本征型阻燃环氧制备的塑封料显示了很好的阻燃性能,均达到了UL94 V-0标准 [17]。
主链中含有联苯结构和苯撑结构的酚醛型环氧树脂和酚醛型环氧固化剂在固化反应后形成了高度阻燃的网络结构,其阻燃性主要归功于在高温下的低弹性和高抗分解性导致燃烧时形成稳定的泡沫层,见图2。泡沫层主要由树脂体、炭和分解时产生的挥发性物质构成,有效地阻隔了热传递[7]。含有亚联苯基团的塑封料比含有对亚苯基的阻燃效果要更明显,这是因为亚联苯基团更长,交联密度更低,更明显的高温
低弹性更有利于泡沫层的形成。
1.2.2 无铅焊料对环氧塑封料的影响
由于环保的要求,现行的集成电路安装使广泛使用的Pb/Sn焊料逐渐被无铅焊料所取代。无铅焊料熔点比Pb/Sn焊料熔点高40℃左右。无铅焊料使用时材料表面温度达到250~260℃[18]。由于封装后材料吸湿,在高达250~260℃的温度
图2 本征型环氧阻燃机理示意图
环境下,水分子快速汽化,同时封装器件的各部分发生热膨胀,由于膨胀系数不匹配,各个界面会产生很大的应力。加工温度提高的同时对材料应力开裂的影响也会增加。因此,使用无铅焊料要求塑封料具有低吸水率、低线膨胀系数、低弹性模量、高粘结性、好的浸润性和高弯曲强度等特点。
1.2.3 液体环氧底填料
⑴ 底填料的基本特点
底填料(UnderFill是一种适用于倒装芯片电路的材料,它是将液体树脂填充在IC芯片与有机基板之间的狭缝中,并且将连接焊点密封保护起来,降低Si芯片和有机基板之间的CTE不匹配;保护器件免受湿气、离子污染物、辐射和诸如机械拉伸、剪切、扭曲、振动等有害操作环境的影响;增强Flip
chip封装的可靠性,与未使用底填料材料的FC-PBGA器件相比,电路的寿命可提高10~100倍[19]。 FC-PBGA的结构如图3所示。由于Si芯片与基板之间的间隙只有几十微米,因此要求液体封装材料具有低豁度、高耐热、低热膨胀系数和低吸水率等特点,此外还要具有良好的工艺性能和储存稳定性。同时还要加人低膨胀的球形填料熔融Si02,合适的粒径范围是2~10µm,大于20um粒径的粒子不超过5% [20]。
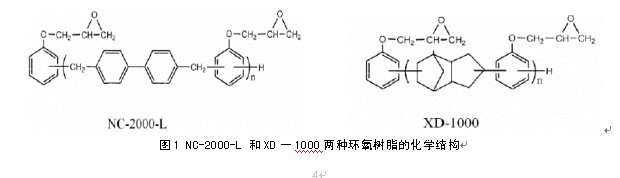 图3 FC-PBGA的结构 图3 FC-PBGA的结构
⑵ 可修复的底填料材料
环氧树脂固化后的热固性或性能上的难控制性严重阻碍了倒装焊芯片封装技术的发展,因为受损的芯片难以从固化的环氧封装料封装后的器件上除去。解决这个问题的有效方法就是使封装料可以修
复,比如在某种条件下,使底层填充的封装料裂解而除去。因此,可修复性的底填料应运而生,目前,这种材料分为化学修复型和热修复型两种类型。
化学修复型材料主要是通过化学溶剂以破坏材料的结构;将含有缩酮或缩醛基团等弱键的二官能团脂环族环氧化合物在含酸性混合溶剂中溶解,可以破坏固化树脂;但溶解环氧交联网状物需要较长的时间。含碳酸酯基的环氧树脂固化物比常规环氧树脂固化物的热分解温度低,其热稳定性按所含基团的种类依下述顺序升高:叔碳酸酯<仲碳酸酯<伯碳酸酯,它们的热分解温度为150~250℃[21][22]。是适宜的热修复型材料。

⑶ no-flow型底填充材料
一种更新的no-flow型的底填料技术逐渐受到了人们的重视。no-flow型的底填料技术不仅能够克服由于液体树脂的毛细流动能力限制的封装尺寸大小,而且还能够有效地提高生产效率[23]。现在的no-flow型底填料研究中也有加人填料的[24],甚至有的no-flow型底填料填料含量也较高,CTE也可以降到3 x 10-5/℃左右,但是这些无机填料的引人妨碍了焊点的形成和限制了焊料的润湿,可能会影响焊接效果[25]。
no-flow型底填料材料中使用的助焊剂必须能够除去金属氧化物,还要保证焊点不会在高温下被重新氧化,而且不能对底填料材料的性能产生明显的负面影响[26]。
参考文献
[1] 祝大同;李小兰;2010年覆铜板行业高层论坛发言摘录——记我国覆铜板业发展形势的一次大讨论 [J]. 覆铜板资讯,2010,3:4-13
[2] 祝大同.PCB基板材料用新型环氧树脂发展综述 [J].印制电路信息.2009.4
[3] 祝大同;日本在覆铜板用新型环氧树脂及其固化剂方面的新发展 [J].覆铜板资讯;2010,1:17~24
[4]小椋一郎(日).最尖端電子デパイス向け新规高牲能エポキシ樹脂及び硬化剂の开发动向.JET1.2009.9
[5]小椋一郎(日).最先端分野に适合でき高次の特殊高耐热性エポキシ榭脂.JETI.2006.9
[6] 森田高示、竹越正明、高根沢伸、坂井和永(日)薄型パツケージ对应基板MCL-E-G79G下.日立化成テクニカルレポート.No.51(2008-7)
[7] 日立化成工业(株)(日).次世代薄型パツケージ基板用低热膨张材MCL-E-G79GT. JPCA.July.2008
[8] 日立化成专利.特开2007-314782
[9] 小椋一郎(日).高牲能特殊液状エポキシ榭脂の技術開發.JET1.2008.9
[10] 青山知之(日).臭素フリ一エポキシ樹脂硬化剂システム[フロロジツク]シスJET1.2009.9
[11] 押见克彦(日).環境に贡献るすエポキシ樹脂の技術開發.JET1.2008.9
[12] 押见克彦;日本化药公司专利.特开2009-001783
[13] 京瓷化学公司专利.特开2009-185170
[14] 陶志强,宋涛,杜迓涓,等;微电子封装用环氧材料研究进展半导体技术[J].2010,35[S]:159-163
[15] 李凌;新兴产业用环氧树脂基其固化剂的市场分析 [J].复合材料,2011,2-3:33-35
[16] MASATOSHI I .Flame retardant composition:United States,6156865[P] thermosetting.2000-O5-12
[17] MASATOSHI YUKIHIRO K. Self-extinguishing resin epoxy molding electronic compound with no flame-
retarding additives for components [J].Journal of Materials Science: Materials in Electronics,2001,12(12):715-723.
[18] 田名波.电子封装工程「M].北京:清华大学出版社,2003:410-411.
[19] ZHANG Z Q,WONG G P. Recent advances in flip-chip underfill: materials, process, and reliability [J].IEEE Transactions on Advanced Packaging,2004,27(3):515-524.
[20] KINOSE Y, MIYABE S, SAKAMOTO T. Fused spherical silica, method for producing same and liquid sealing resin composition:United States,6365649「P].2002-02-04.
[21] WANG L, LI H,WONG G P. Syntheses and characterizations of thermally reworkable epoxy resins [J] . J Polym Sci , Part A Polym Ghem,2000,38(20):3771-3782.
[22] YANG S, CHEN J S, KORNER H, et al. Reworkable epoxies:thermosets with thermally cleavable groups for controlled network breakdown [J]. Chemistry of Materials,1998,10(6):1475-1482.
[23] CHAN Y C, FAN S H, HUNG K C .The effect of metal oxide on the no-flow underfill fluxing capacity [J]. Materials Science and Engineering:8,2001,85(1):64-69.
[24] SHI S H, WONG C P. Study on the relationship between the surface composition of copper pads and no-
flow underfill fluxing capability [J]. IEEE Trans on Electronics Packaging Manufacturing,1999, 22 (4 ): 268-273.
[25] FAN L H, SHI S H,WONG C P.Incorporation of inorganic filler into the no-flow underfill material for flip-chip application [C]//Proc of International Symposium Advanced Packaging Materials: Processes, Properties and Interfaces.Braselton, G A,2000:303-310.
[26] SHI S H,WONG C P. Study of the fluxing agent effects on the properties of no-flow underfill materials for flip-chip applications [J]. IEEE Trans Comp Pack Tech,1999,22(2):141-151
|

 |玻璃钢复合材料商城|联系我们|Archiver|手机版|小黑屋|
FRP玻璃钢复合材料论坛
蜀ICP备10204395号-1
|玻璃钢复合材料商城|联系我们|Archiver|手机版|小黑屋|
FRP玻璃钢复合材料论坛
蜀ICP备10204395号-1